FIB介紹
聚焦離子束技術(Focused Ion beam,FIB)是利用電透鏡將離子束聚焦成非常小尺寸的離子束轟擊材料表面,實現材料的剝離、沉積、注入、切割和改性。隨著納米科技的發展,納米尺度制造業發展迅速,而納米加工就是納米制造業的核心部分,納米加工的代表性方法就是聚焦離子束。近年來發展起來的聚焦離子束技術(FIB)利用高強度聚焦離子束對材料進行納米加工,配合掃描電鏡(SEM)等高倍數電子顯微鏡實時觀察,成為了納米級分析、制造的主要方法。目前已廣泛應用于半導體集成電路修改、離子注入、切割和故障分析等。、
應用領域
(1)線路修改-在IC生產工藝中,發現微區電路蝕刻有錯誤,可利用FIB的切割,斷開原來的電路,再使用定區域噴金,搭接到其他電路上,實現電路修改,最高精度可達5nm。
(2)產品表面存在微納米級缺陷,如異物、腐蝕、氧化等問題,需觀察缺陷與基材的界面情況,利用FIB就可以準確定位切割,制備缺陷位置截面樣品,再利用SEM觀察界面情況。
(3)微米級尺寸的樣品,經過表面處理形成薄膜,需要觀察薄膜的結構、與基材的結合程度,可利用FIB切割制樣,再使用SEM觀察。

FEI V400
使用設備:FEI V400
可以針對14nm,16nm,28nm, 40nm, 45nm, 65nm, .13um, .18um, .25um, .35um 制程進行線路改造。適用的封裝形式BGA, QFN, CSP, WLBGA, Die and board Level, 8” wafer, packaged “flip-chip”
| FIB典型照片 | |
| 觀測 | 線路修改 |
 | 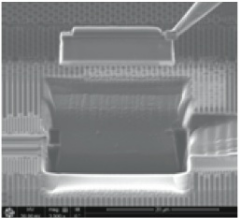 |
| FIB配合TEM進行復雜操作 | |
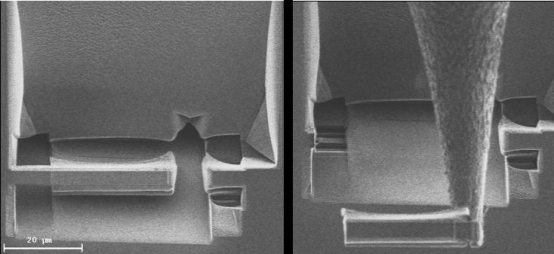 |
文章引用自正衡檢測官網
歡迎各位蒞臨正衡檢測網站討論咨詢http://www.zenh.com/